Dans ce tutoriel, nous détaillons toutes les étapes impliquées dans la fabrication d'un dispositif microfluidique, à travers l'exemple d'une puce de double émulsion et de piégeage. Ce protocole, inspiré et extrait des articles écrits par Ho, Lee et Liu publiés en 2016 dans Scientific Reports et par Kole et al. publiés en 2015 dans J. Res. Natl. Inst. Stand. Technologie, vous donnera les clés, de la conception à la microfabrication, pour construire votre propre dispositif.
Conception d'un dispositif
La conception présentée ci-dessous a été conçue pour générer des gouttelettes à double émulsion.
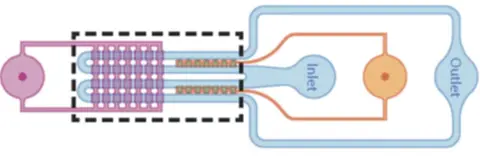
Vous trouverez ci-dessous un protocole détaillé (extrait de Kole et al., publié en 2015 dans J. Res. Natl. Inst) qui vous permettra de concevoir un dispositif microfluidique :
1. Tout d'abord, il est nécessaire d'utiliser un logiciel de conception assistée par ordinateur (CAO) pour concevoir le dispositif microfluidique.
2. Ensuite, nous vous conseillons d'utiliser le contour d'une tranche de 100 mm de diamètre (cela dépend évidemment des dimensions de votre dispositif) et un méplat standard comme limite extérieure du dispositif matriciel, et de graver les caractéristiques du dispositif au centre, à environ 90 mm de la tranche, afin d'éviter d'éventuels défauts de bord.
3. Pour fabriquer un dispositif avec plusieurs niveaux de lithographie, nécessitant l'application de résine photosensible sur les éléments structurés et l'alignement entre les niveaux de lithographie ultérieurs, nous recommandons les indications suivantes :
3.1. Vous pouvez placer les caractéristiques du dispositif, telles que les repères d'alignement inférieurs du substrat, sur le premier niveau de conception. Cet ordre est optimal pour structurer des éléments avec des dimensions verticales nanométriques dans un film de résine photosensible plat, appliqué de manière conforme à un substrat non structuré.
Si les dimensions verticales des éléments structurés dans les niveaux de photolithographie ultérieurs sont critiques, et si la conception du dispositif et du réseau le permet, placez les éléments des niveaux inférieurs vers la périphérie du réseau. Ce placement réduira alors la variation d'épaisseur du film de résine photosensible déposé par centrifugation sur ces éléments de niveau inférieur à des emplacements plus proches du centre de la tranche où les éléments de niveau supérieur seront ensuite placés.
3.2 Ensuite, les repères d'alignement inférieurs doivent être placés vers la périphérie de la tranche pour améliorer l'alignement angulaire et réduire la variation radiale résultante de l'épaisseur du film, et à des endroits qui n'interfèrent pas avec les caractéristiques du dispositif. Le placement idéal des repères d'alignement inférieurs permet l'utilisation d'une seule bande de ruban linéaire pour masquer plusieurs repères d'alignement inférieurs pendant le revêtement centrifuge de la résine photosensible sans couvrir les caractéristiques du dispositif. Cela maintient la visibilité des repères d'alignement inférieurs tout en atteignant des niveaux supérieurs de photolithographie. Il est recommandé d'inclure au moins une paire de repères d'alignement inférieurs pour chaque niveau supérieur de photolithographie.
3.3. Dans cette troisième étape, vous pouvez placer les caractéristiques du dispositif telles que les canaux microfluidiques, les réservoirs d'entrée et de sortie, et les repères d'alignement du photomask supérieur sur les niveaux de conception supérieurs. Si les dimensions verticales de ces éléments sont critiques, et si la conception du dispositif et de la puce le permet, alors vous pouvez placer ces éléments de niveau supérieur plus près du centre de la tranche. Ce placement bénéficiera de la variation réduite de l'épaisseur du film due à l'application d'une résine photosensible centrifuge aux éléments de niveau inférieur qui sont placés de manière optimale vers la périphérie de la puce. Ainsi, les repères d'alignement inférieurs sur le substrat devraient être visibles à travers les repères d'alignement supérieurs sur le photomask, qui seront majoritairement opaques pour la modélisation d'une structure de moule dans une résine photosensible à tonalité négative.
4. Enfin, pendant le processus de photolithographie, vous pouvez aligner les repères d'alignement complémentaires à travers le photomasque sur le substrat.
Structuration d'un moule de dispositif
Il existe de nombreuses approches possibles pour la fabrication d'un moule pour un dispositif microfluidique, utilisant différents matériaux et méthodes. L'approche la plus largement utilisée est une approche photolithographique, idéalement adaptée au prototypage rapide. Elle consiste à revêtir et à modéliser par centrifugation le SU-8, une résine photosensible négative à base d'époxy, sur une tranche de silicium. Le moule en silicium pour le substrat supérieur a été réalisé par structuration SU-8 double couche, dans laquelle la première couche structurée définit la section transversale des micropipettes, les structures de piégeage et le canal microfluidique, tandis que la deuxième couche définit les structures de piégeage et le canal microfluidique principal. Le moule en silicium pour le substrat inférieur a été réalisé par structuration SU-8 monocouche, qui définit les structures de piégeage et le canal microfluidique principal.
Moule en silicium pour le substrat supérieur
1. La première étape consiste en un spin-coating d'un film nanométrique de SU-8 2010 sur un wafer de silicium nu.
1.1. Pour ce faire, centrez le wafer de silicium sur le mandrin d'une centrifugeuse à l'aide d'un gabarit de centrage.
1.2 Déposez environ 10 ml de SU-8 2010 au centre du wafer, en veillant à ne pas créer de bulles d'air.
1.3. La première couche du substrat supérieur, SU-8 2010, est déposée par spin-coating sur un wafer de silicium à 5000 tr/min, ce qui a donné une épaisseur de 8 µm.
2. Chauffer la tranche de silicium recouverte d'un film nanométrique de SU-8 2010 à 95° C pendant 2 min sur une plaque chauffante.
3. La première exposition photolithographique du film nanométrique de SU-8 2010 doit ensuite être réalisée.
3.1. Pour ce faire, placez le wafer de silicium avec le film nanométrique de SU-8 2010 et le premier photomasque dans l'aligneur par contact.
3.2. Placez le wafer de silicium avec le film nanométrique de SU-8 2010 et le photomasque en contact doux.
3.3. Utilisez un filtre i-line pour exposer le film nanométrique de SU-8 2010 à une longueur d'onde de 365 nm avec une dose de 80 mJ.cm-2.
4. Après l'exposition, recuire la tranche de silicium recouverte du film nanométrique de SU-8 2010 sur une plaque chauffante à 95 °C pendant 2 minutes.
5. Le motif peut maintenant être développé dans le film nanométrique exposé de SU-8 2010.
5.1. Pour ce faire, immerger la tranche de silicium recouverte du film nanométrique de SU-8 2010 exposé dans le révélateur SU-8 pendant 1 minute avec une agitation douce.
5.2. Ensuite, rincer la tranche de silicium présentant les motifs développés en SU-8 2010 dans de l'alcool isopropylique pendant 10 s et sécher par soufflage à l'azote.
6. Cuire la plaquette de silicium avec les motifs développés dans le SU-8 2010 sur une plaque chauffante à 150 °C pendant 30 min. Ces motifs adhèrent fermement au substrat.
7. Masquez les zones du wafer de silicium avec des repères d'alignement inférieurs gravés dans le SU-8 2010 à l'aide d'une bande de ruban de masquage d'une largeur de 6 mm (0,25 po) par exemple. Ce ruban de masquage couvrira les repères d'alignement inférieurs pendant le processus de revêtement centrifuge. Ne couvrez pas les zones du wafer de silicium où des caractéristiques de dispositif de niveau supérieur seront gravées, car cela empêcherait la photolithographie dans ces zones.
8. Il est maintenant possible de déposer par centrifugation la deuxième couche de SU-8 2010 sur le wafer de silicium masqué avec les premiers motifs de SU-8 2010.
8.1. Pour ce faire, centrez le wafer de silicium avec les motifs de SU-8 2010 sur le mandrin d'une centrifugeuse à l'aide d'un gabarit de centrage.
8.2 Déposez environ 10 ml de SU-8 2010 au centre du wafer, en veillant à ne pas créer de bulles d'air.
8.3 Pour la deuxième couche, le SU-8 2010 est appliqué avec une vitesse de rotation de 2000 tr/min et donne une épaisseur totale de 15 µm
9. Vous pouvez maintenant retirer le ruban de masquage
10. Cuire la plaquette avec un film microscopique de SU-8 2010 sur une plaque chauffante à 95 °C pendant 8 minutes.
11. Vous pouvez maintenant procéder à la seconde exposition photolithographique du film microscopique de SU-8 2010.
11.1. Pour ce faire, placer la plaquette de silicium avec le film à micro-échelle de SU-8 2010 dans l'aligneur par contact, ainsi que le second photomasque pour les caractéristiques à micro-échelle du dispositif.
11.2. Aligner les marques nanométriques précédemment tracées avec les marques microscopiques sur le photomasque. Veiller à aligner les marques d'alignement supérieures et inférieures.
11.3. Placer la plaquette de silicium avec le film à micro-échelle de SU-8 2010 et le photomasque en contact doux.
11.4. Utiliser un filtre i-line pour exposer le film de SU-8 2010 à une longueur d'onde de 365 nm avec une dose de 160 mJ.cm-2.
12. Après l'exposition, faites cuire la tranche de silicium avec le film microscopique de SU-8 2010 exposé sur la plaque chauffante à 95 °C pendant 8 minutes.
13. Il est maintenant temps de développer le motif dans le film microscopique de SU-8 2010 exposé.
13.1. Pour ce faire, préparez deux récipients de révélateur SU-8 pour une première élimination en vrac du SU-8 2010, suivie d'un rinçage de nettoyage.
13.2 Immergez la tranche avec le film microscopique de SU-8 2010 exposé dans le premier récipient pendant 45 s avec une agitation douce.
13.3 Immergez la tranche avec le film microscopique de SU-8 2010 partiellement développé dans le second récipient avec une agitation douce pendant 30 s.
13.4. Rincez la tranche avec un film microscopique de SU-8 2010 entièrement développé avec de l'alcool isopropylique et séchez-la à l'azote.
14. Inspecter le moule du dispositif résultant par microscopie optique. Si des résidus de SU-8 2010 persistent, rincer le wafer.
Moule en silicium pour le substrat inférieur
Pour le substrat inférieur, une seule couche de SU-8 2010 a été structurée avec une épaisseur de 15 µm sous une vitesse de rotation de 1500 tr/min.
Il est recommandé de mesurer l'épaisseur du film des éléments structurés du SU-8 2010 en utilisant, par exemple, un profilomètre de surface à sonde ou un microscope à force atomique.
Moulage d'un dispositif
Après la fabrication des moules en silicium, ils ont été coulés avec du PDMS (Sylgard-184). La couche de contrôle a été coulée dans un rapport de mélange de 7:1 (base:agent de durcissement). La membrane du canal d'écoulement a été générée par enduction par centrifugation de PDMS avec un rapport de mélange de 20:1 sur le moule en silicium de la couche d'écoulement. Il est important de noter que la membrane PDMS entre en contact avec le fond du canal d'écoulement à 30, 25 et 20 psi pour les dispositifs avec des vitesses d'enduction par centrifugation de PDMS de 1000, 1200 et 1600 tr/min respectivement. Après que le substrat de contrôle en PDMS ait été découpé et que des trous aient été punchés, le substrat de contrôle en PDMS découpé et la membrane de la couche d'écoulement en PDMS sur le moule en silicium ont tous deux été placés dans un graveur plasma à oxygène. Le substrat de la couche de contrôle en PDMS découpé a ensuite été soigneusement aligné et lié à la membrane de la couche d'écoulement en PDMS à l'aide d'une plateforme d'alignement personnalisée sur un microscope optique. Une fine membrane PDMS sépare le canal microfluidique et les couches de contrôle qui remplissent deux fonctions différentes et sont contrôlées indépendamment. Pour diriger le flux vers les chambres de piégeage, un ensemble de vannes à commande pneumatique situé au-dessus du canal microfluidique bloque le flux dans le canal microfluidique principal lorsque l'ensemble de vannes est actionné. Un deuxième ensemble de vannes de contrôle directement au-dessus des chambres de piégeage exerce une compression sur l'émulsion double piégée lorsque l'ensemble de vannes est actionné. Étant donné que les deux ensembles de vannes de contrôle peuvent être contrôlés indépendamment, le piégeage est découplé de la compression. Enfin, le substrat PDMS a été lié à cette lame de verre.
Un dispositif microfluidique à capillaire de verre a été fabriqué en assemblant un capillaire rond effilé, un capillaire carré et des aiguilles de seringue à l'aide d'époxy de 5 minutes. Premièrement, le capillaire de verre rond a été étiré à l'aide d'un tire-pipette. Le capillaire effilé a ensuite été poncé à l'aide de papier de verre de grain 1200 pour obtenir une ouverture de 100 μ m pour le tube de collecte. La surface extérieure d'un tube d'injection propre avec une ouverture de 15 μm, étiré et poncé de manière similaire, a été traitée avec du trichloro(1H,1H,2H,2H-perfluorooctyl)silane pour rendre la surface hydrophobe. Ensuite, le tube d'injection et le tube de collecte ont été insérés dans un capillaire carré placé sur une lame de verre et ils ont été alignés sous un microscope optique. Les aiguilles de seringue ont été coupées et collées à la lame de verre à l'aide d'époxy de 5 minutes. Enfin, des micro-tubes ont été connectés aux aiguilles de seringue.
Piégeage d'émulsions doubles

Des émulsions doubles ont été piégées à l'intérieur du dispositif microfluidique pour l'application de forces mécaniques. Des émulsions doubles d'un diamètre compris entre 40 μm et 90 μm ont d'abord été générées dans un dispositif microfluidique à capillaire de verre, puis réinjectées dans le dispositif microfluidique à une dilution 10x. Pour piéger les émulsions doubles dans les chambres de piégeage, l'ensemble de vannes de contrôle 1 a ensuite été pressurisé à 10 – 15 psi pour bloquer le canal microfluidique principal, ce qui a augmenté la résistance d'écoulement dans le canal microfluidique principal. Le rapport de résistance d'écoulement entre les microcanaux et le canal microfluidique principal diminuera et davantage de lignes de courant de fluide passeront à travers les microcanaux.
Cela augmente considérablement l'efficacité de piégeage des émulsions doubles et il est possible de trouver les 14 chambres de piégeage remplies en une minute. Une émulsion double sera piégée si le rayon de l'émulsion double est inférieur à la largeur de courant critique instantanée, qui est dictée par le rapport de résistance d'écoulement entre la micropipette et le canal microfluidique principal.